在激光惯性约束核聚变实验中 ,靶丸的物性参数和几何参数是靶丸制备工艺改进和仿真模拟核聚变实验过程的基础,因此如何对靶丸多个参数进行同步、高精度、无损的综合检测是激光惯性约束核聚变实验中的关键问题。以上各种薄膜厚度及折射率的测量方法各有利弊,但针对本文实验,仍然无法满足激光核聚变技术对靶丸参数测量的高要求,靶丸参数测量存在以下问题:不能对靶丸进行破坏性切割测量,否则,被破坏后的靶丸无法用于于下一步工艺处理或者打靶实验;需要同时测得靶丸的多个参数,不同参数的单独测量,无法提供靶丸制备和核聚变反应过程中发生的结构变化现象和规律,并且效率低下、没有统一的测量标准。靶丸属于自支撑球形薄膜结构,曲面应力大、难展平的特点导致靶丸与基底不能完全贴合,在微区内可看作类薄膜结构白光干涉膜厚测量技术的优化需要对实验方法和算法进行改进 。白光干涉膜厚仪找谁
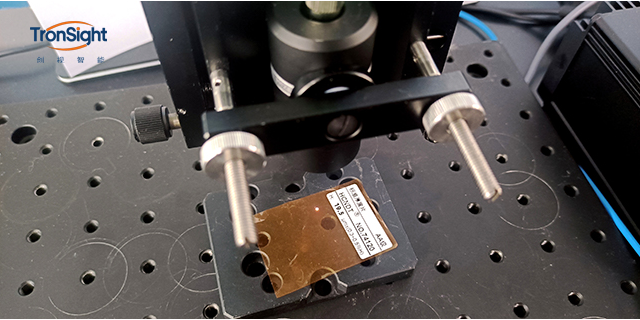
光谱法是以光的干涉效应为基础的一种薄膜厚度测量方法 ,分为反射法和透射法两类[12]。入射光在薄膜-基底-薄膜界面上的反射和透射会引起多光束干涉效应,不同特性的薄膜材料的反射率和透过率曲线是不同的,并且在全光谱范围内与厚度之间是一一对应关系。因此,根据这一光谱特性可以得到薄膜的厚度以及光学参数。光谱法的优点是可以同时测量多个参数且可以有效的排除解的多值性,测量范围广,是一种无损测量技术;缺点是对样品薄膜表面条件的依赖性强,测量稳定性较差,因而测量精度不高;对于不同材料的薄膜需要使用不同波段的光源等。目前,这种方法主要应用于有机薄膜的厚度测量。高精度膜厚仪以客为尊操作需要一定的专业素养和经验,需要进行充分的培训和实践。

为了分析白光反射光谱的测量范围 ,开展了不同壁厚的靶丸壳层白光反射光谱测量实验。图是不同壳层厚度靶丸的白光反射光谱测量曲线,如图所示,对于壳层厚度30μm的靶丸,其白光反射光谱各谱峰非常密集、干涉级次数值大;此外,由于靶丸壳层的吸收,壁厚较大的靶丸信号强度相对较弱。随着靶丸壳层厚度的进一步增加,其白光反射光谱各谱峰将更加密集,难以实现对各干涉谱峰波长的测量。为实现较大厚度靶丸壳层厚度的白光反射光谱测量,需采用红外的宽谱光源和光谱探测器。对于壳层厚度为μm的靶丸,测量的波峰相对较少,容易实现靶丸壳层白光反射光谱谱峰波长的准确测量;随着靶丸壳层厚度的进一步减小,两干涉信号之间的光程差差异非常小,以至于他们的光谱信号中只有一个干涉波峰,基于峰值探测的白光反射光谱方法难以实现其厚度的测量;为实现较小厚度靶丸壳层厚度的白光反射光谱测量,可采用紫外的宽谱光源和光谱探测器提升其探测厚度下限。
白光扫描干涉法采用白光为光源 ,压电陶瓷驱动参考镜进行扫描 ,干涉条纹扫过被测面,通过感知相干峰位置来获得表面形貌信息。测量原理图如图1-5所示。而对于薄膜的测量,上下表面形貌、粗糙度、厚度等信息能通过一次测量得到,但是由于薄膜上下表面的反射,会使提取出来的白光干涉信号出现双峰形式,变得更复杂。另外,由于白光扫描法需要扫描过程,因此测量时间较长而且易受外界干扰。基于图像分割技术的薄膜结构测试方法,实现了对双峰干涉信号的自动分离,实现了薄膜厚度的测量。随着技术的进步和应用领域的拓展,白光干涉膜厚仪的性能和功能将不断提高和扩展;

针对微米级工业薄膜厚度测量 ,研究了基于宽光谱干涉的反射式法测量方法。根据薄膜干涉及光谱共聚焦原理 ,综合考虑成本、稳定性、体积等因素要求,研制了满足工业应用的小型薄膜厚度测量系统。根据波长分辨下的薄膜反射干涉光谱模型,结合经典模态分解和非均匀傅里叶变换思想,提出了一种基于相位功率谱分析的膜厚解算算法,能有效利用全光谱数据准确提取相位变化,对由环境噪声带来的假频干扰,具有很好的抗干扰性。通过对PVC标准厚度片,PCB板芯片膜层及锗基SiO2膜层的测量实验对系统性能进行了验证,结果表明测厚系统具有1~75μm厚度的测量量程,μm.的测量不确定度。由于无需对焦,可在10ms内完成单次测量,满足工业级测量高效便捷的应用要求。白光干涉膜厚测量技术可以实现对薄膜的快速测量和分析 。白光干涉膜厚仪行情
该仪器的使用需要一定的专业技能和经验,操作前需要进行充分的培训和实践。白光干涉膜厚仪找谁
薄膜作为改善器件性能的重要途径,被广泛应用于现代光学 、电子 、医疗、能源、建材等技术领域。受薄膜制备工艺及生产环境影响,成品薄膜存在厚度分布不均、表面粗糙度大等问题,导致其光学及物理性能达不到设计要求,严重影响成品的性能及应用。随着薄膜生产技术的迅速发展,准确测量和科学评价薄膜特性作为研究热点,也引起产业界的高度重视。厚度作为关键指标直接影响薄膜工作特性,合理监控薄膜厚度对于及时调整生产工艺参数、降低加工成本、提高生产效率及企业竞争力等具有重要作用和深远意义。然而,对于市场份额占比大的微米级工业薄膜,除要求测量系统不仅具有百纳米级的测量精度之外,还要求具备体积小、稳定性好的特点,以适应工业现场环境的在线检测需求。目前光学薄膜测厚方法仍无法兼顾高精度、轻小体积,以及合理的系统成本,而具备纳米级测量分辨力的商用薄膜测厚仪器往往价格昂贵、体积较大,且无法响应工业生产现场的在线测量需求。基于以上分析,本课题提出基于反射光谱原理的高精度工业薄膜厚度测量解决方案,研制小型化、低成本的薄膜厚度测量系统,并提出无需标定样品的高效稳定的膜厚计算算法。研发的系统可以实现微米级工业薄膜的厚度测量。白光干涉膜厚仪找谁